

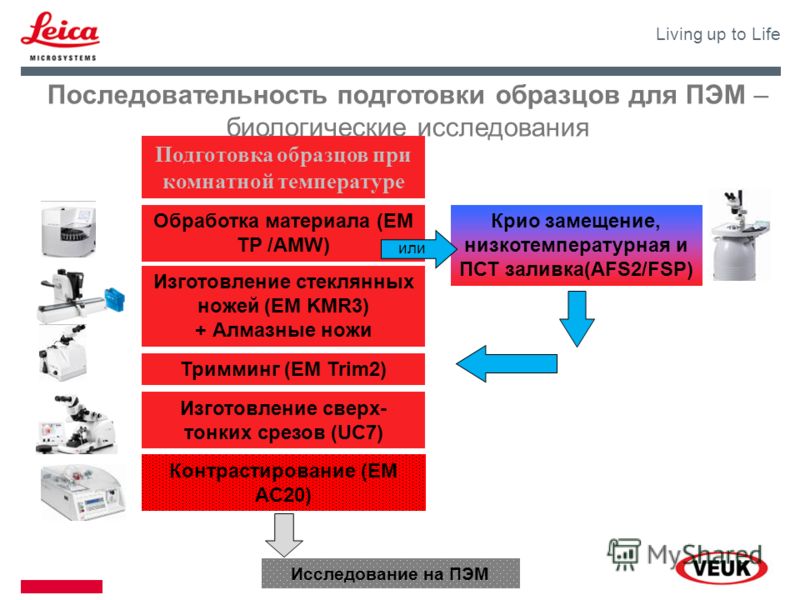








Категория: Бланки/Образцы
Место РЭМ в микроскопии.Растровый электронный микроскоп (РЭМ) формирует изображение объекта при сканировании его поверхности электронным зондом. Это один из наиболее универсальных приборов для исследования микроструктурных характеристик металла (табл. 1). По темпам развития и количеству моделей РЭМ опережает просвечивающие электронные микроскопы (ПЭМ), так число микрофотографий, полученных на РЭМ приближается к числу фотографий полученных на световом микроскопе и значительно превосходит ПЭМ. По разрешающей способности РЭМ занимает промежуточное положение между ПЭМ и СМ (табл. 2). Но не следует рассматривать их как конкурирующие приборы, скорее они дополняют друг друга.
ИНФОРМАЦИЯ ПОЛУЧАЕМАЯ С ПОМОЩЬЮ РЭМ
Способ формирования контраста
Вторичные электроны (основной), отраженные электроны, поглощенный ток, катодолюминесценция
Рентгеновское излучение (основной), отраженные электроны, поглощенный ток, катодолюминесценция, Оже-электроны
Электрические и магнитные поля в образце
Вольтовый контраст, магнитный контраст (прошедшие электроны, отраженные электроны, поглощенный ток)
Электрические свойства полупроводников
Внутренние токи и напряжения
СРАВНИТЕЛЬНАЯ ХАРАКТЕРИСТИКА МИКРОСКОРОВ РАЗЛИЧНЫХ ТИПОВ
Можно указать следующие преимущества и недостатки растровой электронной микроскопии :
1) Разрешающая способность и глубина фокуса на два порядка превышает значения для СМ. Разрешающая способность ПЭМ при исследовании реплик и РЭМ при непосредственном исследовании образцов практически равны. Подготовка образцов так же проста, что выгодно отличает его от ПЭМ. РЭМ широко применяется в металлографических исследованиях при увеличениях 300-10000, при меньших целесообразно использование СМ. По разрешающей способности РЭМ уступает ПЭМ, к тому же ему недоступна информация об объеме металла (фольги), что разделяет области использования данных приборов.
2) При наличии соответствующих приставок к РЭМ имеется возможность проведения рентгеносректрального и катодолюминисцентного анализов, электронной спектроскопии, изучения магнитных и электрических микрополей, дифракционных эффектов и т.д. Имеется возможность изучения динамических процессов непосредственно в РЭМ (процессы при механическом нагружении металлов, нагреве, охлаждении и т.д.).
3) Применяемый в РЭМ поточечный принцип формирования изображения позволяет использовать микро-ЭВМ для количественного анализа изображения и обработки результатов измерений.
 Эффекты, возникающие при взаимодействии электронного пучка с веществом и используемые для формирования изображения в РЭМ:1–эл.пучок; 2–образец; 3–отраженные электроны; 4–вторичные эл.; 5–ток погложенных эл.; 6 – катодолюминесценция; 7–рентген. излучение; 8–Оже-электроны; 9–неведенный ток; 10–прошедшие эл.
Эффекты, возникающие при взаимодействии электронного пучка с веществом и используемые для формирования изображения в РЭМ:1–эл.пучок; 2–образец; 3–отраженные электроны; 4–вторичные эл.; 5–ток погложенных эл.; 6 – катодолюминесценция; 7–рентген. излучение; 8–Оже-электроны; 9–неведенный ток; 10–прошедшие эл.
Конструкция и принцип работы. В конструкции РЭМ можно выделить следующие основные системы: электронно-оптическую, формирующую электронный зонд и обеспечивающую его сканирование по поверхности образца, систему формирующую изображение, вакуумную систему, устройства точной механики. В РЭМ поверхность исследуемого массивного образца облучается стабильным по времени тонко сфокусированным (диаметр до 1,5-5 нм) электронным зондом, развертывающимся в растр. Растр – совокупность близко расположенных параллельных линий, вдоль которых зонд обегает выбранный участок поверхности образца. В результате взаимодействии зонда с веществом образца возникает ряд различных процессов (рассеяние, прохождение и отражение электронов, рентгеновское излучение и т.д (рис.)). Результаты взаимодействия регистрируются соответствующими датчиками. Полученные сигналы, после детектирования и усиления модулируют яркость электронно-лучевой трубки (ЭЛТ), развертка которой синхронизована со смещением электронного зонда. Таким образом между точками растра на поверхности образца и точками растра на ЭЛТ существует взаимно однозначное соответствие, причем яркость точек на ЭЛТ определяется интенсивностью сигнала из соответствующей точки образца. Увеличение РЭМ определяется соотношением амплитуд развертки луча по экрану ЭЛТ и зонда по поверхности образца. Если размер поля зрения на образце равен l. а на ЭЛТ L (постоянная величина), то линейное увеличение будет M = L/l. Таким образом, уменьшение участка сканирования приводит к росту увеличения изображения.
Энергия электронов зонда может меняться в широких пределах – от 0,2 до 50 кэВ, что позволяет выбрать оптимальные условия получения изображения. В результате воздействия зонда образец эмитирует электроны, распределение которых по энергиям представлено на рис. Область I соответствует электронам, называемыми отраженными. Это электроны, которые, испытав ряд взаимодействий и теряя при этом энергию, изменяют направления движения и покидают образец. Часть их энергии передается электронам образца, что приводит к образованию вторичных электронов со средней энергией порядка нескольких электрон-вольт. Им соответствует область II. имеющая высокий максимум.
Наибольшая разрешающая способность достигается при использовании сигнала вторичных электронов, поскольку область генерации большей их части невелика и мало отличается от размеров электронного зонда. Именно для этого случая приводятся паспортные характеристики приборов.
Размеры области генерации отраженных электронов значительно больше и зависят от длины пробега электрона в материале образца, который быстро растет с увеличением ускоряющего напряжения и уменьшением среднего атомного номера мишени. Поэтому разрешающая способность РЭМ в режиме регистрации отраженных электронов значительно хуже и может меняться в значительных пределах.
В режиме детектирования поглощенных электронов (поглощенного тока) сигналом является разность между током зонда (постоянная величина) и суммой токов отраженных и вторичных электронов. Поэтому в этом случае область генерации совпадает с областью генерации отраженных электронов.
Размеры области генерации рентгеновского излучения зависят от материала образца и ускоряющего напряжения и изменяются от одного до нескольких микрометров даже при минимальном размере зонда.
Детектирование сигналов и формирование контраста изображения. Из информации, получаемой с помощью РЭМ, наиболее часто используемыми являются сведения о локальных изменениях рельефа и химического состава поверхности. Соответственно выделяют топографический и композиционный контраст. Они образуются при использовании сигналов от вторичных и отраженных электронов и поглощенного тока. Обычно в РЭМ используются парные симметрично расположенные относительно зонда детекторы отраженных электронов. Это позволяет различить топографическую и композиционную составляющую контраста. Топографический контраст обусловлен тем, что на детектор попадут только те электроны, область испускания которых находится в зоне прямой видимости детектора, а их количество зависит от угла наклона локального участка поверхности. Причиной возникновения композиционного контраста является увеличение выхода отраженных электронов при увеличении атомной массы мишени. Принцип действия парного детектора показан на рис. Сигналы обуславливающие композиционный контраст, в обоих детекторах эквивалентны, а обуславливающие топографический – обратны. Суммирование сигналов от детекторов (А+В) увеличивает композиционный контраст и уничтожает топографический. А вычитание сигналов (А-В) подавляет композиционный и выявляет топографию поверхности. Современные РЭМ позволяют использую композиционный контраст, разделять фазы, отличающиеся по среднему атомному номеру меньше чем на единицу. Однако при исследовании объектов с сильно развитым рельефом полностью подавить топографическую составляющую контраста не удается.
Наличие топографического контраста при использовании сигнала вторичных электронов обусловлено зависимостью коэффициента эмиссии от угла наклона участка поверхности к электронному зонду. Характерной особенностью является повышенная яркость изображения острых вершин и выступов рельефа (краевой эффект), вызванный увеличением выхода электронов с этих участков. Композиционный контраст в режиме детектирования вторичных электронов относительно мал и используется очень редко.
Детектором поглощенного тока является сам образец. Сигнал поглощенного тока зависит от количества эмитированных вторичных и отраженных электронов, и контраст, создаваемый им, равен с обратным знаком контрасту детектора, который собирал бы все электроны. В нем присутствует и топографическая и композиционная составляющая.
Кроме рассмотренных основных видов контраста, существует еще ряд механизмов его образования, значительно увеличивающих объем информации которую можно получить при помощи РЭМ.
Причиной появления кристаллографического контраста является аномальное поглощение (каналирование) электронов при их движении в направлении, близком к направлению удовлетворяющему закону Вульфа-Брегга. Обычно наблюдается в режиме детектирования отраженных электронов.
Магнитный контраст объясняется влиянием магнитного поля на траекторию движения электронов и, как следствие, искажает их пространственное распределение. Различают магнитный контраст I и II типа в случае если магнитное поле выходит и не выходит за пределы образца. I тип наблюдается в режиме детектирования вторичных электронов, II тип в режиме детектирования отраженных электронов. Используется для изучения доменной структуры металла.
Вольтовый контраст появляется вследствие изменения эффективности регистрации вторичных электронов при изменении потенциала объекта. Применяется для изделий микроэлектроники.
Сигнал тока, индуцированного электронным зондом, может измеряться во внешней цепи. Появляется в полупроводниках вследствие генерации пар электрон–дырка электронами зонда.
Кадодолюминисцентное излучение детектируется световодом, соединенным с фотоумножителем.

4.2. Подготовка образцов для исследования на растровом электронном микроскопе 53
– возможность проведения исследований в статическом и динамическом режимах, позволяющая успешно изучать непосредственно в РЭМ процессы, протекающие при механическом нагружении материалов, нагреве, охлаждении, воздействии среды и т.д.;
– электронно-зондовая система и принцип формирования изображения, позволяющие использовать ЭВМ для автоматизации количественного анализа изображения и обработки результатов измерений.
К недостаткам РЭМ относят высокую стоимость, невозможность
выявления структуры внутри образца, отсутствие цветного изображения, необходимость помещения образца в вакуум, радиационные повреждения некоторых материалов в процессе исследования, затруднения при изучении диэлектриков.
4.2. ПОДГОТОВКА ОБРАЗЦОВ ДЛЯ ИССЛЕДОВАНИЯ НА РАСТРОВОМ
Подготовка образцов для исследования на растровом электронном микроскопе достаточно проста, однако следует соблюдать определенные требования, связанные с особенностями реализации метода [2].
Размер образцов ограничен размером сменных объектодержателей, которыми оснащен прибор. Во многих используемых в настоящее время микроскопах диаметр объектодержателей составляет 20 мм, высота не более 10 мм. Могут быть изучены образцы меньших размеров, в том числе менее 1 мм (тонкая проволока, лента, порошки и др.).
При резке образцов для исследования на РЭМ необходимо избегать нагрева и загрязнений исследуемой поверхности. В этом случае поверхность, подлежащая анализу, тщательно закрывается фольгой. Во избежание нагрева резка производится медленно, с остановками, применяется охлаждение водой или эмульсией. После резки следы эмульсии или влаги удаляются, затем фольга снимается, образец промывается в спирте или ацетоне и обдувается сжатым воздухом до полного удаления жидкости.
Наличие загрязнений на поверхности изломов неблагоприятно влияет на вторичную эмиссию, вносит искажения при формировании изображения. Некоторые посторонние частицы, заряжаясь пучком электронов, отклоняют его. Наличие окисной пленки существенно
Глава 4. РАСТРОВАЯ ЭЛЕКТРОННАЯ МИКРОСКОПИЯ
снижает разрешение деталей изображения. Так же как в ПЭМ, рекомендуется изучать изломы непосредственно после разрушения.
Образцы в объектодержателе могут быть закреплены специальным электропроводящим клеем. При недостаточном контакте образца с объектодержателем изображение значительно ухудшается.
4.3. ОСОБЕННОСТИ РАСТРОВОГО ЭЛЕКТРОННОГО МИКРОСКОПА
Растровые электронные микроскопы обеспечивают увеличение от х5 до
х200 000. При проведении фрактографических исследований максимальное увеличение обычно не превышает х30000. Разрешающая способность РЭМ составляет примерно100 A. Глубина фокуса в 300 раз больше, чем светового микроскопа. Это соответствует глубине фокуса более 1000 мкм при увеличении х1000 и около 10 мкм при увеличении х10000. Образцы можно наклонять более чем на 45 о в любом направлении, не изменяя фокусировки. Рабочее расстояние от объективной линзы до образца составляет обычно от 10 до 25 мм.
Основными системами и устройствами растрового электронного микроскопа являются (рис. 4.3) [3]: электронно-оптическая система, формирующая электронный зонд и обеспечивающая его сканирование по поверхности образца; вакуумная автоматизированная система и устройства точной механики (шлюзы, держатели образцов, устройства разнообразного механического воздействия на образцы и т.д.). В состав электронно-оптической системы входят электронная пушка, электромагнитные линзы, диафрагма и катушки отклоняющей системы. Электронная пушка, являющаяся источником электронов, состоит из катода, фокусирующего электрода и анода. Анод заземлен, а катод и фокусирующий электрод соединены с источником высокого напряжения (обычно 10 … 30 кВ, иногда 1,5 кВ).
При использовании электронных пушек из тонкой вольфрамовой проволоки пучок электронов создается за счет термоэмиссии. Электронные пушки с катодами из острозаточенных стержней гексаборида лантана, окруженных нагревательной спиралью, и автоэмиссионные пушки с холодным катодом имеют большую яркость и меньший эффективный размер катода, однако стабильность получаемого пучка обеспечивается только при высоком и сверхвысоком вакууме.

4.3. Особенности растрового электронного микроскопа
Глава 4. РАСТРОВАЯ ЭЛЕКТРОННАЯ МИКРОСКОПИЯ
Эмиттированные катодом электроны ускоряются и формируются в пучок, проходящий через диафрагму, конденсорные линзы и объективную линзу, которые существенно уменьшают изображение источника электронов, фокусируя его на поверхность образца.
Внутри объективной линзы находятся две пары отклоняющих катушек, которые соединены с генератором развертки, обеспечивающим синхронную развертку электронного зонда и луча электронно-лучевой трубки в квадратный растр. Развертка осуществляется в двух взаимно перпендикулярных направлениях, число строк в кадре составляет от 500 до 1000. Применяют быструю развертку (как в телевизионной системе) и медленную. Время сканирования изменяется от нескольких секунд (при визуальном наблюдении) до минут (при фотографировании). Стигматор используют для коррекции астигматизма, вызванного асимметрией магнитного поля линзы.
Разрешающая способность растрового электронного микроскопа определяется диаметром электронного зонда (чем меньше диаметр, тем больше разрешающая способность микроскопа), который в свою очередь зависит от электронной оптики, размера кончика катода, эмиттирующего электроны, тока электронного пучка и ускоряющего напряжения.
Когда на поверхность излома попадает сфокусированный пучок первичных электронов, возникает несколько сигналов (рис. 3.1) [1]: эмиттируются отраженные и вторичные электроны, катодолюминисценция и рентгеновское излучение, часть потока электронов проходит через образец, а часть поглощается. С точки зрения фрактографии наибольший интерес представляют вторичные электроны и упругоотраженные (электроны, рассеянные в обратном направлении).
Электроны, покидающие поверхность образца, улавливаются детектором или коллектором. Соответствующий сигнал усиливается и используется для управления яркостью пятна электроннолучевой трубки. Это пятно отражает интенсивность сигнала, возникающего в анализируемой точке на образце при взаимодействии с электронным зондом. Изображение создается путем подключения сканирующего генератора к отклоняющим катушкам в колонне электронного микроскопа и к отклоняющим пластинам принимающей электроннолучевой трубки. Отклоняемый пучок электронов образует растр на поверхности излома, который на электроннолучевой трубке демонстрируется при большем увеличении. Яркость (контраст) изображения, сформированного по точечному
4.3. Особенности растрового электронного микроскопа
принципу, модулируется сигналом, зависящим от количества электронов, покидающих поверхность излома в каждый момент. Использование электроннолучевых трубок с длительным послесвечением делает возможным визуальное наблюдение всего изображения.
Во фрактографических исследованиях обычно используются вторичные и отраженные электроны. Предпочтение почти всегда отдается вторичным, так как они обеспечивают лучшее разрешение, а также позволяют изучать затененные участки образцов. Однако в некоторых случаях целесообразно пожертвовать разрешающей способностью для улучшения контраста изображения, особенно для гладких образцов при небольших увеличениях. Это достигается при использовании режима работы микроскопа в отраженных электронах.
Отраженные электроны обладают высокой энергией, большой скоростью и движутся по прямолинейным траекториям от образца к детектору, вызывая «теневые» эффекты и, следовательно, высокий контраст изображения. Для режима работы в отраженных электронах характерно существенное снижение разрешающей способности. Отраженные электроны генерируются в образце на глубине до 300 A. Благодаря рассеянию внутри образца, эффективный диаметр зоны генерации отраженных электронов намного больше, чем диаметр электронного зонда. В то же время вторичные электроны обладают энергией около 20…50 эВ, которой достаточно для выхода из поверхностного слоя толщиной 100 A. Таким образом, поверхностный слой толщиной 100 A служит источником вторичных электронов, которые могут достигать детектора. Разница в величине областей генерации этих двух типов электронов обусловливает различия в получаемой разрешающей способности.
Относительное количество вторичных и отраженных электронов, улавливаемых детектором, регулируется напряжением смещения на детекторе. Типичный детектор вторичных электронов представлен на рис. 4.4 [3]. Он состоит из цилиндра Фарадея (заземленного металлического экрана, полностью защищающего внутреннее пространство от посторонних электростатических влияний) с сеткой, к которой приложено напряжение смещения в интервале (+250) … (–30) В. Положительное напряжение служит для сбора вторичных электронов (с низкой энергией и скоростью), но не влияет на траекторию отраженных электронов. При повышении напряжения смещения захватывается более значительное количество вторичных электронов. Если напряжение

ЭлектроСцинтиллятор Световод статическая линза
Рис. 4.4. Схема типичного детектора вторичных электронов
Рис. 4.4. Схема типичного детектора вторичных электронов
Электроны, проходящие через сетку коллектора, ускоряются до такой степени, что их энергии становится достаточно для активации сцинтиллятора и образования светового излучения. Световод, присоединенный к сцинтиллятору, передает световое излучение к фотоумножительному устройству, где оно преобразуется в электрические сигналы, используемые для модуляции яркости электроннолучевой трубки. Хотя детектор вторичных электронов также может быть использован для сбора отраженных электронов (путем передвижения и изменения напряжения смещения на сетке), более эффективно применение двух отдельных детекторов.
Одним из основных назначений растровой электронной микроскопии является анализ поверхностей разрушения материалов при приложении различных внешних нагрузок. В табл. 4.2 [1] представлена классификация изломов по основным признакам. В любом изломе испытуемого образца или конкретной детали можно выделить очаг
4.3. Особенности растрового электронного микроскопа
разрушения, зону зарождения трещины, зону развития трещины и зону долома. Участок излома, в котором произошло зарождение трещины, называют очагом разрушения. Поверхность разрушения, прилегающая к очагу зарождения трещины, представляет собой зону зарождения трещины. Участок излома, находящийся вдали от очага зарождения трещины, является зоной развития трещины. Зона развития трещины в итоге переходит в зону долома объекта.
Различают трещины первичные, распространяющиеся из очага разрушения и образующие поверхность разрушения, и вторичные, распространяющиеся из отдельных центров разрушения, расположенных на поверхности излома. Поверхность излома характеризуется наличием таких элементов, как фасетки скола, ямки, ступеньки, ручьи, язычки и гребни отрыва. По связи с элементами структуры изломы делятся на внутризеренные и межзеренные.
Для описания микростроения изломов используются такие понятия, как скол, квазискол, механизм слияния микропустот. Скол представляет собой механизм хрупкого разрушения, при котором происходит разделение металла по плоскостям, совпадающим с кристаллографическими плоскостями зерен (внутризеренный скол) или с плоскими участками границ зерен (межзеренный скол). Скол характеризуется поверхностью разрушения, состоящей из фасеток, соизмеримых с размерами зерен, и практически не имеет признаков пластической деформации.
Квазискол – механизм внутризеренного квазихрупкого разрушения, характеризующийся разделением металла по плоскостям, не совпадающим с кристаллографическими плоскостями зерен. Характеризуется поверхностью разрушения, состоящей из фасеток, имеющих размеры меньше размеров зерен, со слабо выраженными признаками локальной пластической деформации.
Слияние микропустот представляет собой механизм внутризеренного или межзеренного вязкого разрушения, характеризующийся разделением металла путем зарождения, роста и слияния микропор при пластическом течении металла. Этот механизм характеризуется поверхностью разрушения, имеющей ямочный микрорельеф с разной степенью развития ямок и значительной пластической деформацией всей поверхности.
Глава 4. РАСТРОВАЯ ЭЛЕКТРОННАЯ МИКРОСКОПИЯ
1. Металловедение и термическая обработка стали: справ. изд. – 3-е изд. перераб. и доп. В 3 т. Т. 1. Методы испытаний и исследования / Под ред. М.Л. Бернштейна, А.Г. Рахштадта. – М. Металлургия, 1983. – 252 с.
2. Электронная микроскопия в металловедении: справ. изд. / А.В. Смирнова, Г.А. Кокорин, С.М. Полонская и др. – М. Металлургия, 1985. – 192 с.
3. Фрактография и атлас фрактограмм / Под ред. Дж. Феллоуза. – М. Металлургия, 1982. – 488 с.
4. Практическая растровая электронная микроскопия / Под ред. Дж. Гоулдстейна и Х. Яковица. – М. Мир, 1978. – 656 с.
5. Микроанализ и растровая электронная микроскопия / Под ред. Ф. Морис, Л. Мени, Р. Тискье. – М. Металлургия, 1985. – 392 с.

СКАНИРУЮЩАЯ ЗОНДОВАЯ МИКРОСКОПИЯ
В настоящее время хорошо известно, что многие важнейшие свойства реальных объектов, в том числе и металлических, в значительной степени определяются состоянием их поверхности. Свойства поверхностных слоев существенно отличаются от свойств объема материала, что связано с особенностями их тонкого (атомного) строения, взаимодействием поверхности с атмосферой и сопрягаемыми твердыми телами. Изучение поверхностных слоев в последние годы стало одной из важнейших задач материаловедения. На решение этих задач направлены усилия многих специалистов. Знания, полученные при изучении поверхностных явлений, обеспечили успехи в области современных нанотехнологий. Для успешного решения отмеченных выше задач очень важным является наличие информативных, удобных,
доступных методов исследования поверхности.
В последние 10–15 лет при исследовании материалов различной природы, в том числе и металлических, широкое распространение получили методы сканирующей зондовой микроскопии (СЗМ). Речь идет о сканирующей туннельной микроскопии (СТМ) и атомно-силовой микроскопии (АСМ) [1–6]. В англоязычной литературе для обозначения указанных выше методов исследования используются следующие обозначения: SPM (Scanning Probe Microscopy), STM (Scanning Tunnelling Microscopy), AFM (Atomic Force Microscopy).
Важнейшим достоинством методов СТМ и АСМ является то, что они позволяют с очень высоким разрешением сформировать трехмерное изображение поверхности исследуемого материала. Эти методы имеют много общего и часто используются параллельно. Важнейшей
Глава 5. СКАНИРУЮЩАЯ ЗОНДОВАЯ МИКРОСКОПИЯ
особенностью, характерной для методов сканирующей зондовой микроскопии, является их относительная дешевизна. По сравнению с электронной микроскопией туннельная и атомно-силовая микроскопия на порядок дешевле. Особо следует подчеркнуть возможность реализации методов сканирующей зондовой микроскопии на воздухе. Это обстоятельство резко упрощает методику проведения исследований.
С появлением методов сканирующей зондовой микроскопии стало вполне реальным решение задачи наблюдения отдельных атомов или их малых групп на поверхности объектов. Несколько десятилетий назад это казалось нереальным.
До появления сканирующей зондовой микроскопии основным методом изучения поверхности являлся метод дифракции медленных электронов (ДМЭ). За счет низкой энергии электронного пучка электроны, падающие на поверхность объекта исследования, проникают на глубину всего лишь одного-двух атомных слоев. Данные, полученные с применением такого зонда, позволяют говорить о расположении атомов в поверхностном слое изучаемого материала. В то же время метод ДМЭ не позволяет непосредственно отображать отдельные атомы объекта. Информация, полученная с его помощью, является усредненной по некоторой площади поверхности объекта.
Методы зондовой сканирующей микроскопии позволяют наблюдать и оперировать такими малыми объектами строения вещества, как отдельные атомы. Развитие этих методов свидетельствует о возможности новых открытий при изучении поверхностных явлений, физики конденсированного состояния вещества. Несомненно, применение методов сканирующей зондовой микроскопии обеспечит дальнейшее развитие нанотехнологий, в том числе и в области материаловедения.
5.1. СКАНИРУЮЩАЯ ТУННЕЛЬНАЯ МИКРОСКОПИЯ
В 1986 году Нобелевскую премию в области физики получили H. Rohrer (Швейцария) и G. Binning (Германия). Премия этим ученым была присуждена за выдающиеся исследования в разработке одного из
наиболее совершенных методов изучения материалов – сканирующих туннельных микроскопов. Практическое применение этих приборов положило в 1981 году начало новому направлению изучения поверхностных явлений, характерных для материалов различной природы.